





(3D-NAND,DRAM)


Packaging
WLP

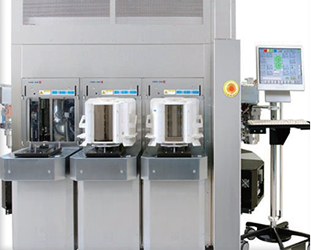
ENTRON™ EX300

RISE™ 300





ENTRON™ SeriesDelivery Record > 500


Main Process Module x 4 + Sub Process Module x 2 + Load Lock Module x 2


Main Process Module x 8 + Sub Process Module x 2 + Load Lock Module x 2

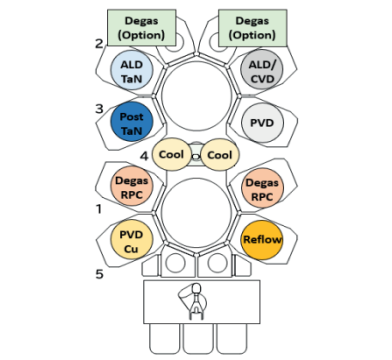

Cu Integraion Process Flow (In situ)

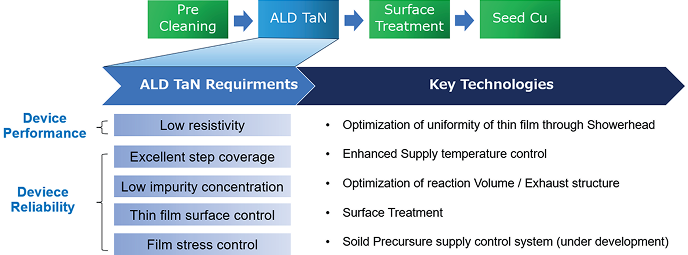

Excellent step coverage
in narrow patterns
Logic Interconnect (Small,Fine Pitch)


ENTRON™-EX W300 Single System
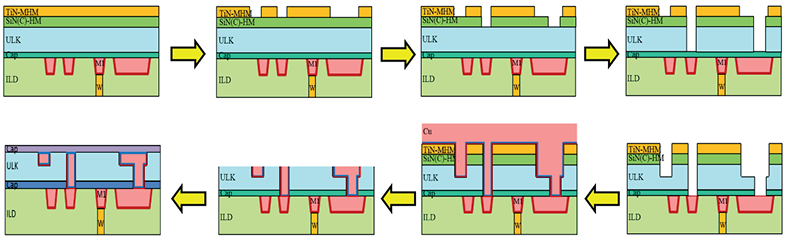

ENTRON-EX W300 Tandem System
Cutting edge technology to Thin& thick films
High Throughput and performance with multi
cluster chamber
LOGIC
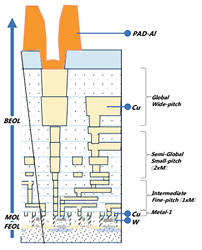
DRAM
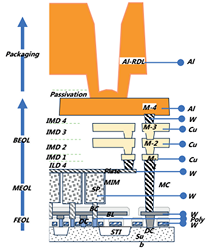
NAND
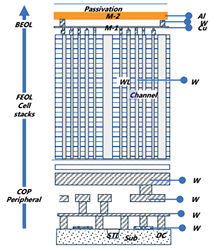

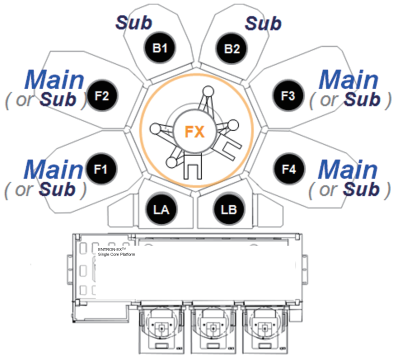
Logic : Interconnection, DRAM & NAND : Gate Electrode, Interconnection, etc.
LOGIC
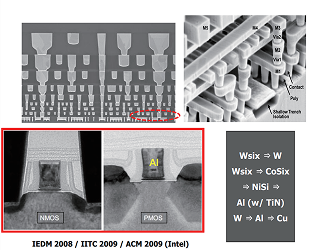
DRAM
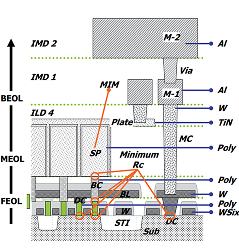
NAND
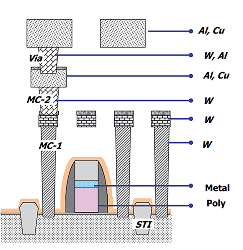

WLP for Cu-RDL : RDL with Chip middle structure, Up to 8 stacked
HBM for Seed layer : Seed layer for micro bump pad to access TSV
2.5D Packaging, Hybrid Bonding, …

| SFEM /Core |
|
|---|---|
| Degas |
|
| Pre-Clean |
|
| Sputter |
|
GPU structure
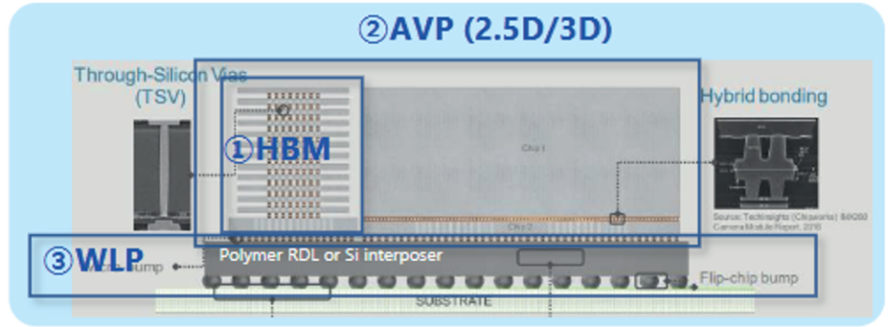


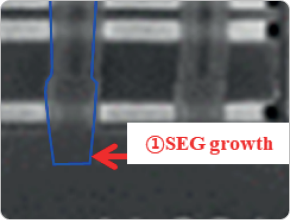

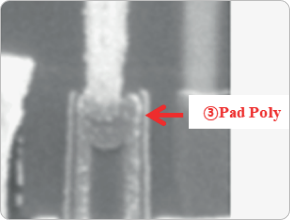

CVD Module

PVD Module

Dry Clean Module


Target erosion profile

Plasma electron tracks
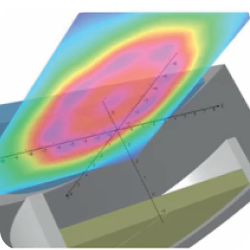
Deposition profile
on the substrate

Voltage distribution

E-Field on plane

RF surface current

Smith chart(Matcher)

Voltage distribution